현재의 반도체 업황은 응용처 뿐 아니라, 제품에 따라서 완전히 차별화 되는 국면이 나오고 있다. 현재 메모리에서 가장 주목해야할 부분은 "High-End DRAM". 삼성전자와 SK하이닉스 2Q 컨콜에서 "DDR5", "LPDDR5" 그리고 "HBM" 을 강조했다.
제품별 차별화

DDR5의 경우는 레거시 수요 부진으로 인한 빠른 전환
LPDDR5의 경우는 아이폰 전모델 채택과 전장용 칩들의 채택율 증가
HBM은 이미 AI수요로 인하여 엄청난 성장.
글로벌 업계1,2위 업체인 테라다인(미), 어드밴테스트(일) 도 비메모리 테스트는 수요의 감소를 우려하고 있으나, 메모리 테스트 시장은 하이엔드 디램으로 인한 강한 수요를 전망.
어드밴스드 패키징의 모든 것
HBM, TSV, 열압착본딩, MR-MUF, 레이저본딩, 하이브리드본딩 패키징
(1) 패키징 시장 규모

전통 패키징 시장은 매년 감소
어드밴스드 패키징 시장은 2022년부터 2028년까지 연평균 23% 성장
(2) 반도체

패키징
- 반도체 칩과 기판을 연결
- 반도체 칩의 경우, 2년에 2배 미세화
- 기판은 4년에 2배 미세화
- 반도체 칩과 기판의 미세화 차이 간극이 증가
→ 간극 메우기 위해 Wire 대신 전송속도 빠른 범프 사용한 BGA 도입
한계 봉착
- 반도체 미세화 비용 급증
- 공정 난이도 증가
- 개발 속도 지연
(3) 연결(본딩)
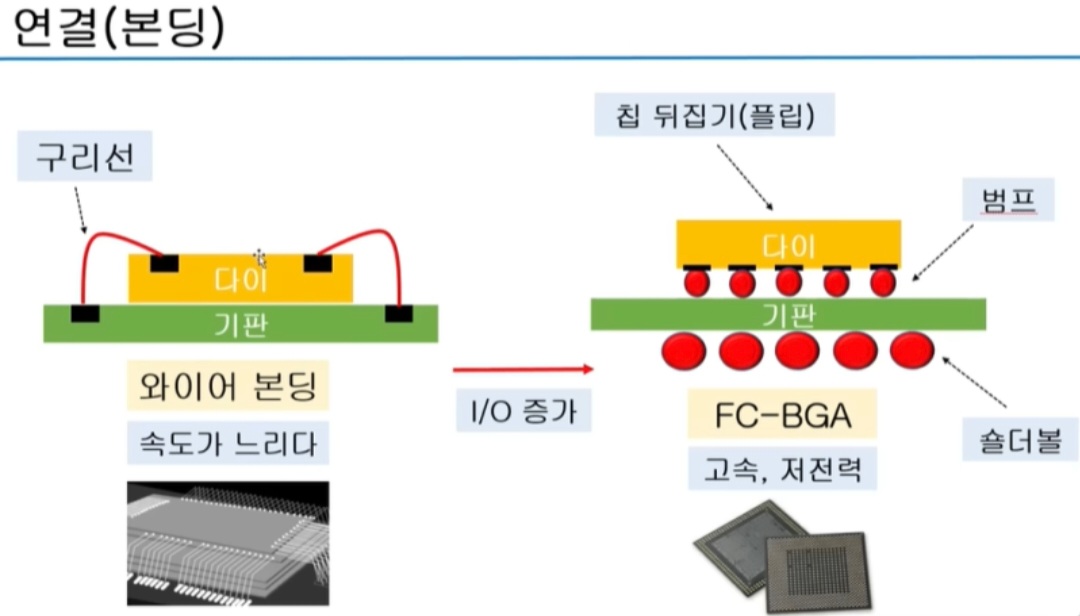
와이어 본딩
- 기판과 다이(반도체 칩)을 구리선으로 연결
- 속도가 느림
- 와이어 연결 면적 limit으로 I/O 제한
FC-BGA
- 기판에 다이(반도체 칩)을 뒤집어서 범프로 연결
- 고속, 저전력
- I/O 증가
(4) WLP(WaferLevel Pacage)

전통 패키징
가공 완료된 웨이퍼를 다이로 잘라서 기판 위에 놓고 패키징
WLP
가공 완료된 웨이퍼 위에 기판을 대신하는 RDL(재배선층) 놓고 절단
(5) FO-WLP
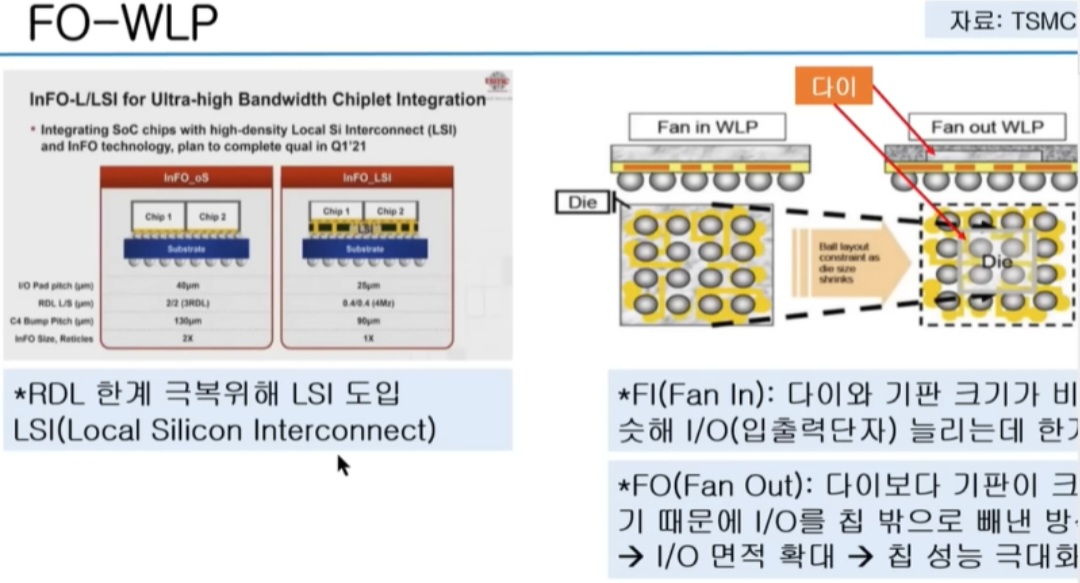
RDL 한계 극복위해 LSI 도입 LSI(Local Silicon Interconnect)
FI(Fan In
다이와 기판 크기가 비슷해 I/O(입출력단자) 늘리는데 한계
FO(Fan Out)
다이보다 기판이 크기 때문에 I/O 를 칩 밖으로 빼낸 방식 → I/O 면적 확대 → 칩 성능 극대화

TSMC
- 패키징 기술 선도 기업
- 2011년 칩렛 기술 개발
- 2016년부터 아이폰 독점 생산
(6) CoWoS - TSMC

CoWoS(Chip On Wafer On Substrate)
- 2.5D 패키징 : 서로 다른 칩을 인터포저(실리콘 공정)를 통해서 하나로 연결
- 2D 패키징 : 인터포저 없이 다른 칩들을 기판을 통해 연결
(7) 인터포저

인터포저(Interposer)
- 직접회로(CPU vs D램, GPU vs D램)의 배선 연결을 도와주는 부품
- 기판 대신 실리콘을 사용하여 열적 안정성을 보유
- 다이 연결 시 TSV 이용
삼성전자
1) I -Cube 8 : 8개의 HBM 구현(2023년)
2) I - Cube 12 : 12개의 HBM 구현 (24년 4분기)
(8) 와이어 본딩 VS TSV
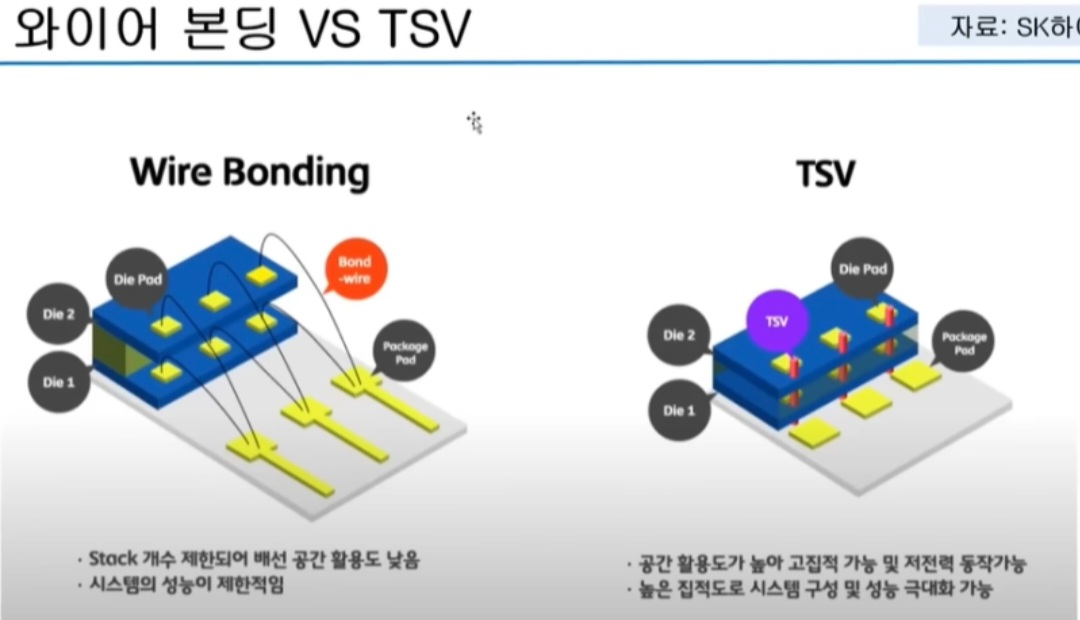
Wire 본딩
- Stack 개수 제한되어 배선 공간 활용도 낮음
- 시스템의 성능이 제한적임
TSV
- 공간 활용도가 높아 고집적 기능 및 저전력 동작 가능
- 높은 집적도 로 시스템 구성 및 성능 극대화 가능
(9) TSV공정
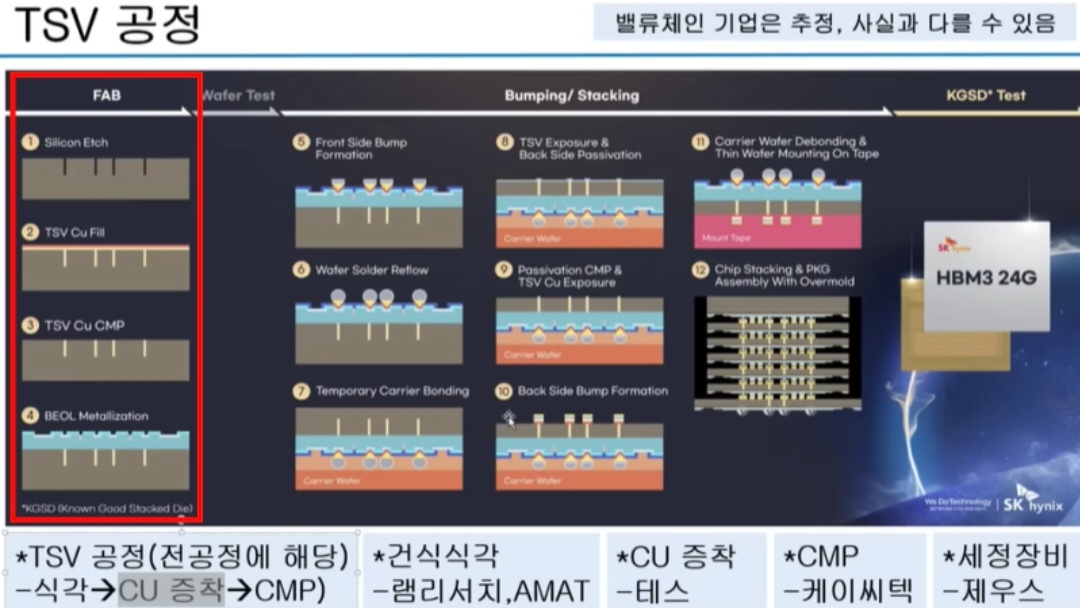
TSV (Through Silicon Via, 작은 통로)
- 다이(칩)과 인터포저를 연결하는 기술
- 칩의 실리콘 기판을 통과하는 수직 전기연결을 생성하는 기술
- 장점:와이어나 플립칩에 비해 더 짧은 인터커넥트 길이로 빠른 전기 신호 전달
2) 고대역폭
3) 전력 소모 감소
(10) 고성장 HBM

트렌드포스
- HBM 공급량 2024년까지 +105% 증가
- 2023년~ 2024년은 AI 개발의 중추 적인 해
- HBM 매출 2024년 +127% 증가, 89억달러(12조원)
모건스탠리 HBM 시장 규모 상향 조정
- 2024년 40억달러 → 96억달러 규모 (13조원)
(11) HBM을 부르는 AI가속기 전쟁
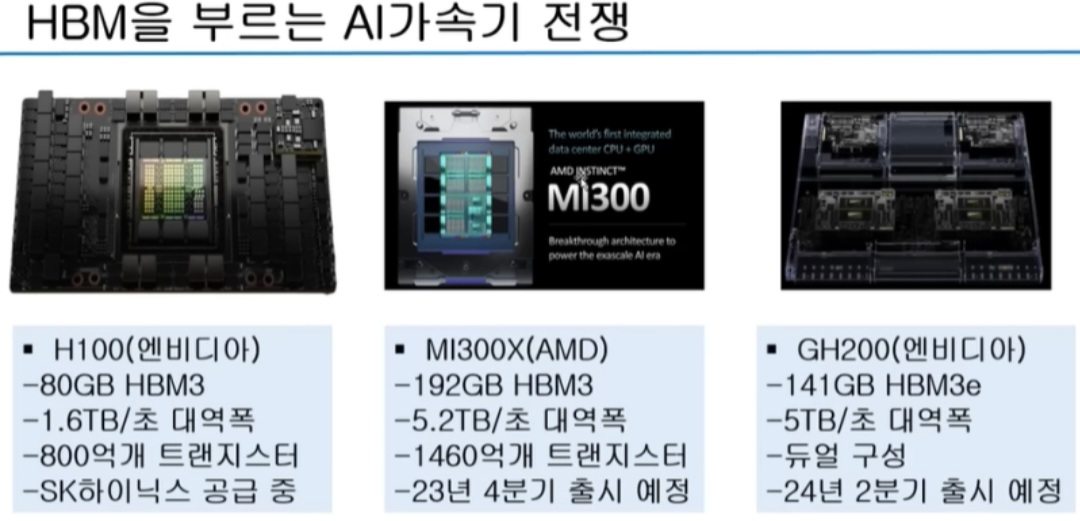
(1) H100 (엔비디아)
- 80GB HBM3
- 1.6TB/초 대역폭
- 800억개 트랜지스터
- SK하이닉스 공급 중
(2) MI300X(AMD)
- 192GB HBM3
- 5.2TB/초 대역폭
- 1460억개 트랜지스터
- 23년 4분기 출시 예정
(3) GH200 (엔비디아)
- 141GB HBM3e
- 5TB/초 대역폭
- 듀얼 구성
- 24년 2분기 출시
(12) 리플로우

열을 가해서 솔더볼(범프)을 녹이고 붙이는 과정
일종의 오븐, 다아를 올린 기판을 놓으면 벨트가 움직이면서 순차로 열을 받게 함
5~7분이라는 긴 시간 동안 칩과 패키지 기판 전체가 열에 노출
-> 휘어짐 현상과 납탬이 제대로 되지 않는 현상 발생
레이저 리플로우

본딩의 종류
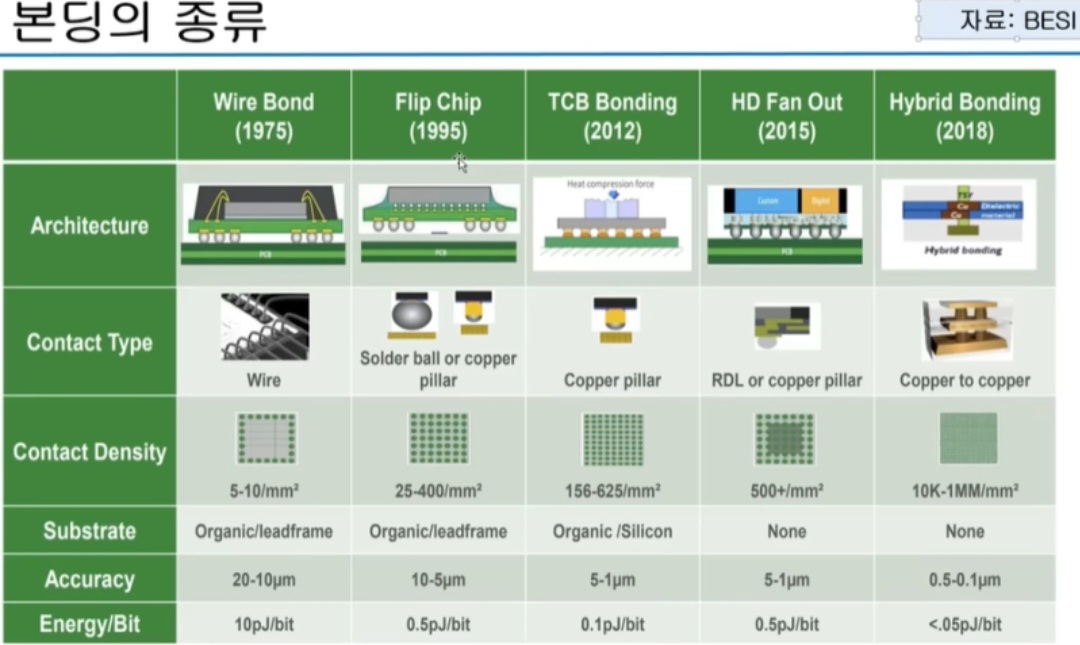
HBM과 본딩의 진화
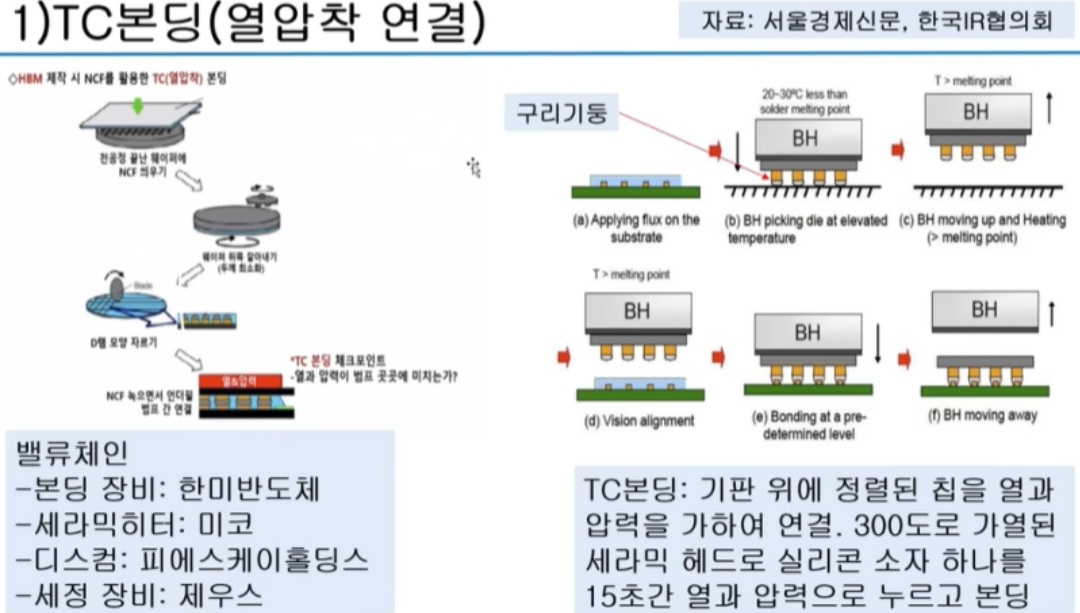
1) TC 본딩(열압착 연결)
밸류체인
- 본딩 장비 : 한미반도체
- 세라믹히터 : 미코
- 디스컴 : 피에스케이홀딩스
- 세정 장비 : 제우스
TC 본딩 : 기판 위에 정렬된 칩을 열과 압력을 가하여 연결. 300도로 가열된 세라믹 헤드로 실리콘 소자 하나를 15초간 열과 압력으로 누르고 본딩
2) MR - MUF

SK하이닉스 5년 이상 연구개발, 세계 최초 (HBM3 적용)
1 . Micro bump 를 부착한 Chip 에 금속결합물질을 도포하여 적층
2 . 대량의 Micro bump 를 한번에 녹여 Chip과 회로 간 연결 사진
3 . Chip 과 Chip, 기판 사이의 빈 공간을 채우고 절연, 외부로부터 하는 몰딩까지 동시에 진행
MR-MUF VS TC-NCF

당 기술은 TC - NCF 와 달리, Chip 간 Gapfill 소재 (NCF)를 Bump 로 고온/가압 관통시킬 필요 없음
대기 상태로 Bonding 하므로, 1) Chip Warpage 제어와 2) Gapfill - MUF 소재가 핵심 기술임
1) Warpage 제어는 Nonwet 수율(대형불량)에, 2) MUF 소재는 Chip 간 Void 품질/신뢰성에 직결
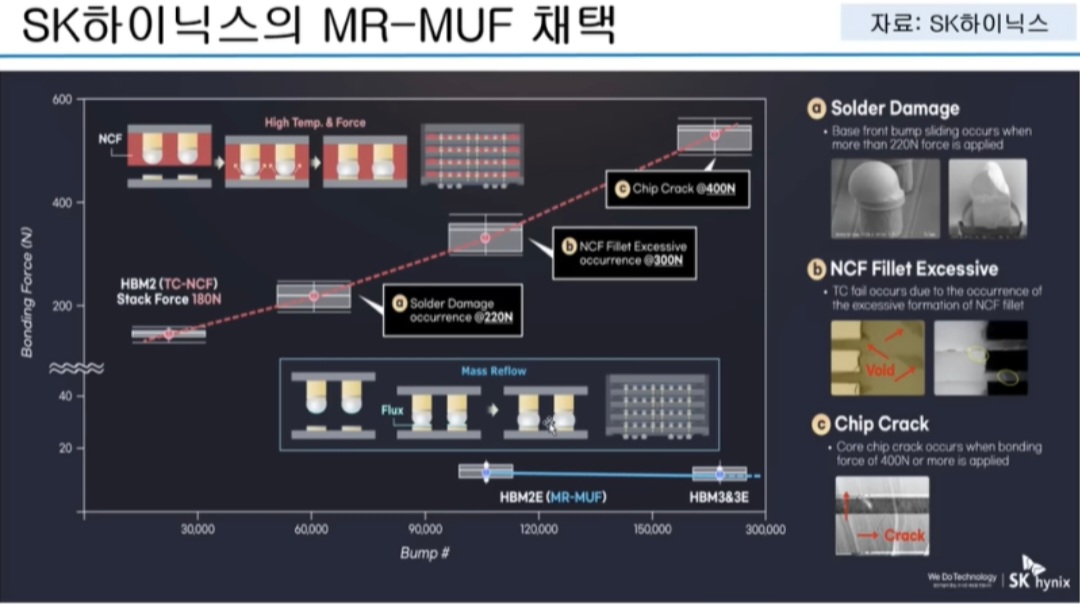
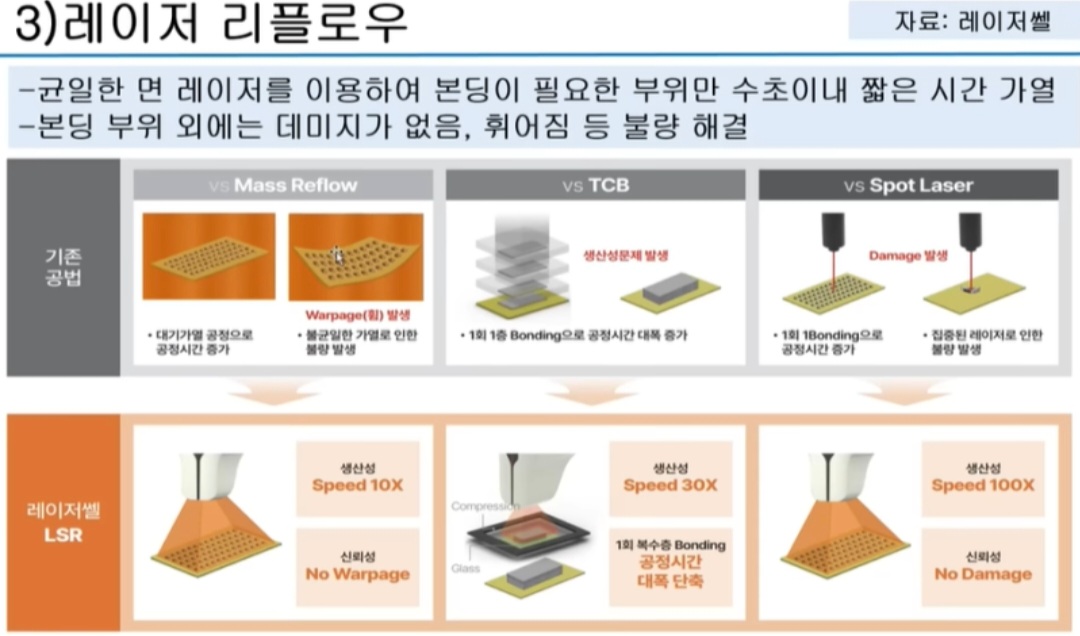
AI 사이클이 촉발하는 GPU와 HBM
HBM이 핫해서 늦었지만 지금부터라도 관심을 가지고 .. HBM 이란 HBM은 DRAM의 일종으로 High Bandwidth Memory이다. 여러개의 D램 칩을 TSV(Through Silicon Via)를 통해 수직 연결함으로써 데이터 처리 속도를 혁
chd0803.tistory.com
HBM 수요 확대 기대 속 관련주 찾기
13일 국내 증시는 미국 추가 긴축 완화 및 HBM 반도체 수요 확대에 따른 수혜 기대감 지속으로 HBM 관련주들 중심으로 강한 상승을 하였다. HBM 관련주 한미반도체 (29.97%) : GPU에 동반되는 HBM을 붙여
chd0803.tistory.com
22년 하반기 반도체 기판 수요 변화 및 실적 전망
반도체 기판 관련주 반도체 기판이라 함은 인쇄 회로 기판을 말한다. 국내 반도체 기판 관련주로 해성디에스, 대덕전자, 코리아써키트, 심텍 , 삼성전기를 대표로 들 수 있다. 반도체 기판의 22년
chd0803.tistory.com
'경제를 배우자.' 카테고리의 다른 글
| HBM 대장주 한미반도체, TSV TC 본더 장비 (1) | 2023.09.13 |
|---|---|
| 테슬라 자율주행 기술의 핵심 도조 슈퍼컴 부각 (0) | 2023.09.12 |
| 9월 셋째주 이슈/산업별 주요 일정 (23.09.12) (0) | 2023.09.12 |
| 미-중 수출통제 제2라운드 (0) | 2023.09.12 |
| 예스티 vs HPSP 특허 분쟁 승자는? (0) | 2023.09.11 |




댓글